-
学术文章
用户成就丨浙江大学皮孝东/王蓉团队新突破!双光子光致发光技术揭开4H-SiC外延层位错半环阵列形成之谜
近日,浙江大学硅及先进半导体材料国家重点实验室、浙江大学材料科学与工程学院皮孝东(Xiaodong Pi )和王蓉(Rong Wang )担任通讯作者,在 Journal of Physics D: Applied Physics 上发表了题为“ Formation mechanism of dislocation half-loop array in 4H-SiC epitaxial layers: effect of triangular defects”的 研究论文(图 1)。该 研究通过光化学(Photo-electrochemical, PEC)刻蚀技术直接揭示了4H-SiC外延层中三角缺陷及其周围的位错半环阵列的三维形貌,并确认了三角缺陷内部的拉伸应力。

图1 研究成果
研究发现,三角缺陷内部的应力在基面位错(Basal Plane Dislocations,BPDs)的形核和滑移以及位错半环阵列的形成中起着关键作用。该研究通过振电科技的UltraView MK- Ⅱ多模态非线性光学显微镜系统-双光子光致发光技术确认了位错半环阵列中的穿晶刃位错(Threading Edge Dislocations, TEDs)对是在4H-SiC外延过程中形成的,而非从衬底继承而来。这一发现为减少厚外延层中的BPD密度、降低邻近器件的双极退化故障率并提高产量提供了重要依据。
UltraView MK- Ⅱ多模态非线性光学显微镜系统-双光子光致发光技术以其卓越的三维成像能力和高分辨率,帮助研究人员深入探究了4H-SiC外延层中位错半环阵列的形成机制。
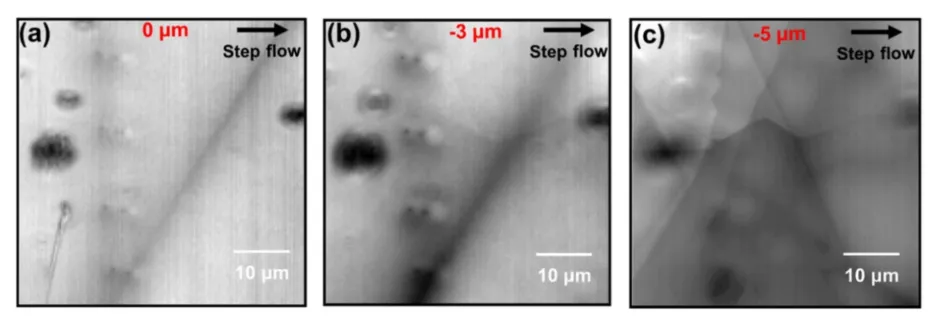
图2 通过UltraView MK- Ⅱ多模态非线性光学显微镜系统-双光子光致发光技术获得的4H-SiC外延层中位错半环阵列的三维成像结果
1、技术助力缺陷可视化
研究人员利用 UltraView MK- Ⅱ多模态非线性光学显微镜系统-双光子光致发光技术,通过752 nm的近红外激发波长,成功实现了对4H-SiC外延层内部结构的非破坏性、高分辨率三维成像(图2)。这种技术不仅能够清晰地识别出位错半环阵列,还能与其他缺陷发射信号区分开来,从而为研究缺陷的形成机制提供了有力支持。
2、位错半环阵列的三维成像
在实验中,研究人员通过UltraView MK- Ⅱ多模态非线性光学显微镜系统-双光子光致发光技术观察到位错半环阵列在三角缺陷附近的形成过程。该技术使得研究人员能够在不同深度(如0 µm、3 µm和5 µm)下对位错半环阵列进行成像, 揭示了这些缺陷阵列并非贯穿整个外延层,而是在距离表面5 µm处开始形成(图2) 。这一发现对于理解位错半环阵列的生成机制至关重要。
UltraView MK- Ⅱ多模态非线性光学显微镜系统-双光子光致发光技术不仅为4H- SiC外延层缺陷的研究提供了强大的工具, 还为相关领域的技术发展和应用提供了新的思路。通过该技术,研究人员能够更深入地理解材料的微观结构和缺陷行为,从而为优化生长工艺、降低缺陷密度以及提高器件性能提供了理论依据。该技术在4H- SiC缺陷研究中的成功应用, 再次证明了其在材料科学领域的先进性和实用性。未来,随着技术的不断进步,该系统有望为更多材料的研究和开发提供支持,推动相关领域的持续发展。





